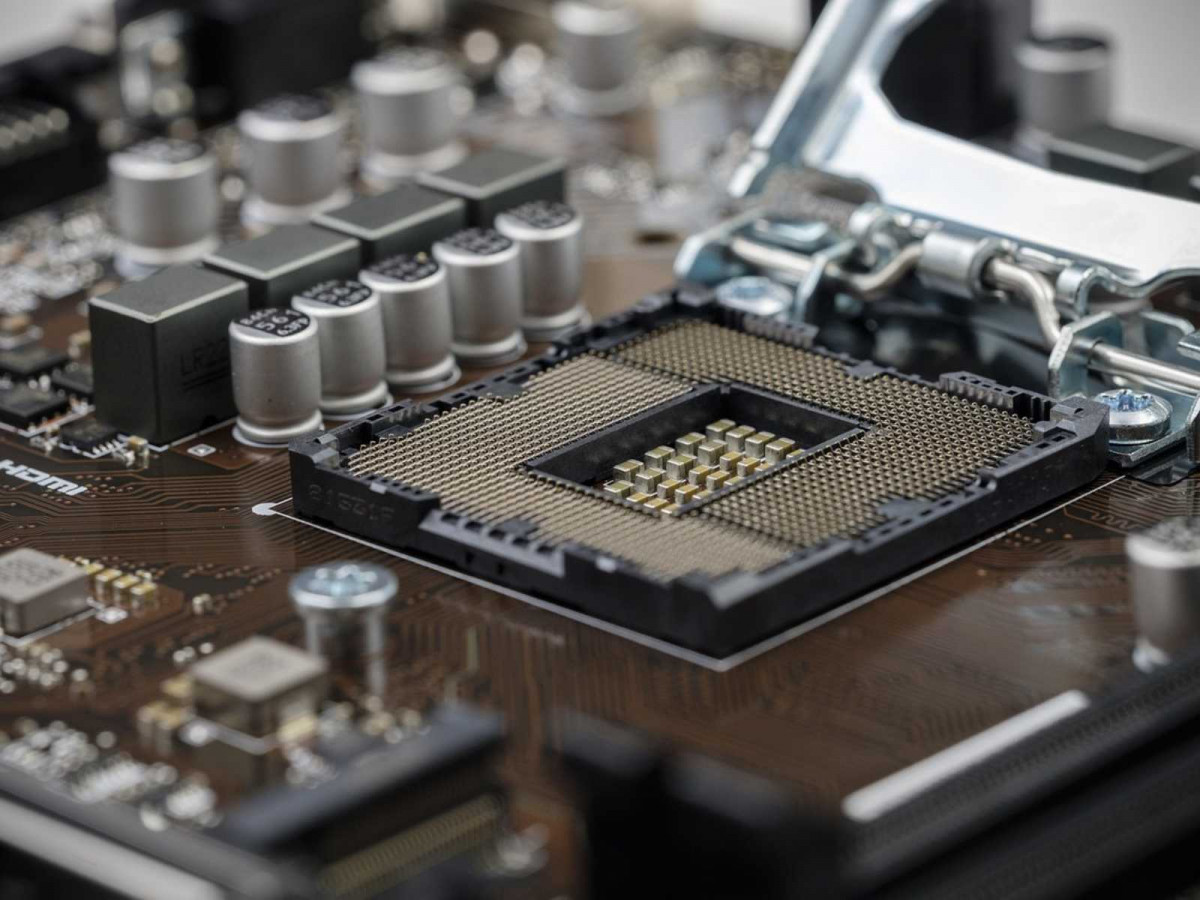
AI台灣半導體供應鏈已成全球焦點,SEMICON Taiwan 2025國際半導體展9/10-12登場,許多「千金股」也將一展風華,究竟有什麼核心競爭力,能夠讓他們笑傲江湖。
SEMI報告指出,2025 Q1全球半導體設備出貨額達320.5億美元,年增21%,由AI、雲端、高效運算與邊緣應用強力帶動,Rubin晶片Tape out的影響將反映在9月10-12日的SEMICON Taiwan 2025,展覽聚焦在AI晶片、先進封裝、3DIC、Chiplet、FOPLP、異質整合、矽光子、量子運算、HBM高頻寬記憶體等項目,其中AI時代所需的複雜設計、先進封裝與異質整合方案與測試流程是焦點中的焦點。
參展的台廠亮點照過來
主要參展公司包括:台積電、聯發科、日月光、精測、穎崴、旺矽、帆宣、弘塑、歐姆龍、NXP、Accordance、Onto Innovation、PDF Solutions、Pentamaster、Park Systems、ZEISS、Orbray株式會社、TMBA工具機、Toray Engineering 。
參展的台廠主要聚焦在先進封裝與異質整合解決方案,重點領域涵蓋:晶圓前/後段檢測、IC、封裝、Chiplet測試、光學、電子、X光檢測、良率追蹤/分析及智慧自動化數據整合,技術發展與應用產品的雙重聚焦落在:晶圓級封裝(WLP)、Fan-Out、3D IC、Chiplet、TSV、HBM異質整合,封裝設計、自動化製程、測試解決方案等全產業鏈創新方案。
台積電封裝技術獨步全球
台積電展出先進CoWoS、SoIC、高階異質整合平台與封裝創新,日月光投控是全球領先的封裝、測試與異質整合解決方案廠商,帆宣、弘塑、旺矽是半導體先進封裝材料、測試、模組設備重點廠商,精測、穎崴提供新世代封裝測試、模組化異質整合樣品座與檢測解決方案。上述公司各自在技術路線、設備創新、系統整合上推動了台灣先進封裝與異質整合的全球競爭優勢,不僅支撐摩爾定律延續,更引領AI、5G、車用等高效能應用蓬勃發展。
台積電領先全球,發展CoWoS(2.5D)、SoIC(3D)、InFO(扇出型)等系列封裝技術。CoWoS將邏輯晶片與記憶體(如HBM)以高頻寬、低延遲方式整合,已是AI、HPC、資料中心主流解決方案;SoIC支援裸晶高密度堆疊,突破傳統製程限制。台積電投資價值不只是製程龍頭,更是系統級封裝平台的制定者,整合CPU、GPU、HBM、I/O的核心。
日月光投控推出VIPack™異質整合平台,融合先進重佈線層(RDL)、2.5D/3D晶片封裝、嵌入式堆疊等,協助客戶在單一封裝整合多晶片功能以提升效能與密度。積極布局AI、HPC、車用、物聯網等新世代晶片市場,每年持續擴展創新封裝解決方案,FOCoS(扇出型晶圓級封裝)與SiP(系統級封裝)已商轉。日月光投控投資價值在於供應鏈不可替代的二哥角色,台積電專注最先進,日月光提供規模化、成本優化方案,互補共存。

發掘實力雄厚的潛力股
精測與旺矽專注於探針卡、PCB基板等CP測試、高階良率分析,隨AI/HPC晶片製程升級,測試技術同步推進。精測的投資價值在於「晶片數量增加、測試點倍增」的供應鏈裡,是最大的槓桿受益者。旺矽投資價值在於測試端的「隱形冠軍」,尤其受惠於AI/Chiplet設計。
設備鏈「隱形推手」看旺
穎崴主力Burn-in/Test Socket,精準支援後段老化測試,協助異質封裝產品持續提升可靠度與良率。穎崴投資價值在於異質整合封裝下,「測試週期更長、複雜度更高」。
帆宣針對半導體產業提供廠務、無塵室、設備材料、工業自動化整合,技術逐步升級至支援EUV/先進封裝產線。帆宣的投資價值在於每一波「新封裝產能擴充」等於帆宣的營收擴張,是設備鏈的「隱性推手」。
弘塑專精於濕製程與晶圓級自動化設備,充分連結異質整合與先進封裝工程自動化需求。弘塑的投資價值在於雖規模小,但屬於「高純度供應鏈」的設備廠,成長彈性大。
更多精彩內容 就在 [理財周刊1306期] 👈點紅字看更多



